HIOKI日置 CN010 电压偏置测试系统

2025-04-09
日置发布了电压偏置测试系统CN010,通过日置LCR测试仪、电压偏置单元搭配定制的测试软件,帮助半导体行业的用户快速完成SiC、GaN、MLCC的偏压测试,轻松把握半导体器件的直流偏置特性研究。

一、测试原理
C-V测量被广泛用于测量半导体参数。研发端的工程师通常使用C-V测量技术来评估新材料,并在开发前进行验证和评估。测试端工程师将对供应商的一些无源元件和电源装置及材料进行资格检查,以检测工艺参数。
HIOKI日置C-V测试系统的回路结构图如下所示,使用LCR表的四端测试方法,将电压源的负端连接到LCR的保护端,并通过偏置单元将其应用到被测对象的两端。采用交流信号注入法获得了不同偏置电压下的阻抗、相位、电容、损耗因子等相关电参数,并用PC软件绘制了特性曲线。
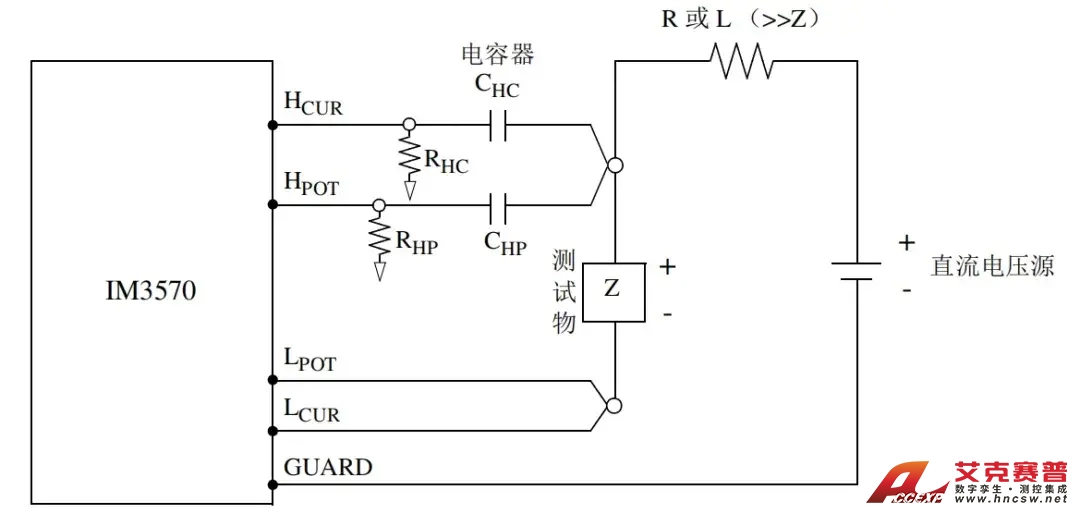
直流电压偏置电路
二、测试应用
1、薄膜电容MLCC(Multi-layor ceramic capacitor)
MLCC贴片电容自身的直流偏压特性(DC Bias Characteristics)—— 在MLCC两端施加直流电压时,直流偏置对极化机制的箝位效应使偶极子的自由翻转更加困难。与不施加直流电压时相比,电压的增加使其介电常数逐渐变小,导致两端直流电压增加过程中呈下降趋势。
大容量的陶瓷电容的标称容值随着外部直流工作点的变化而明显地变化(例如DCDC的输出滤波电容等),因此,在设计电路时需要考虑、计算和验证。
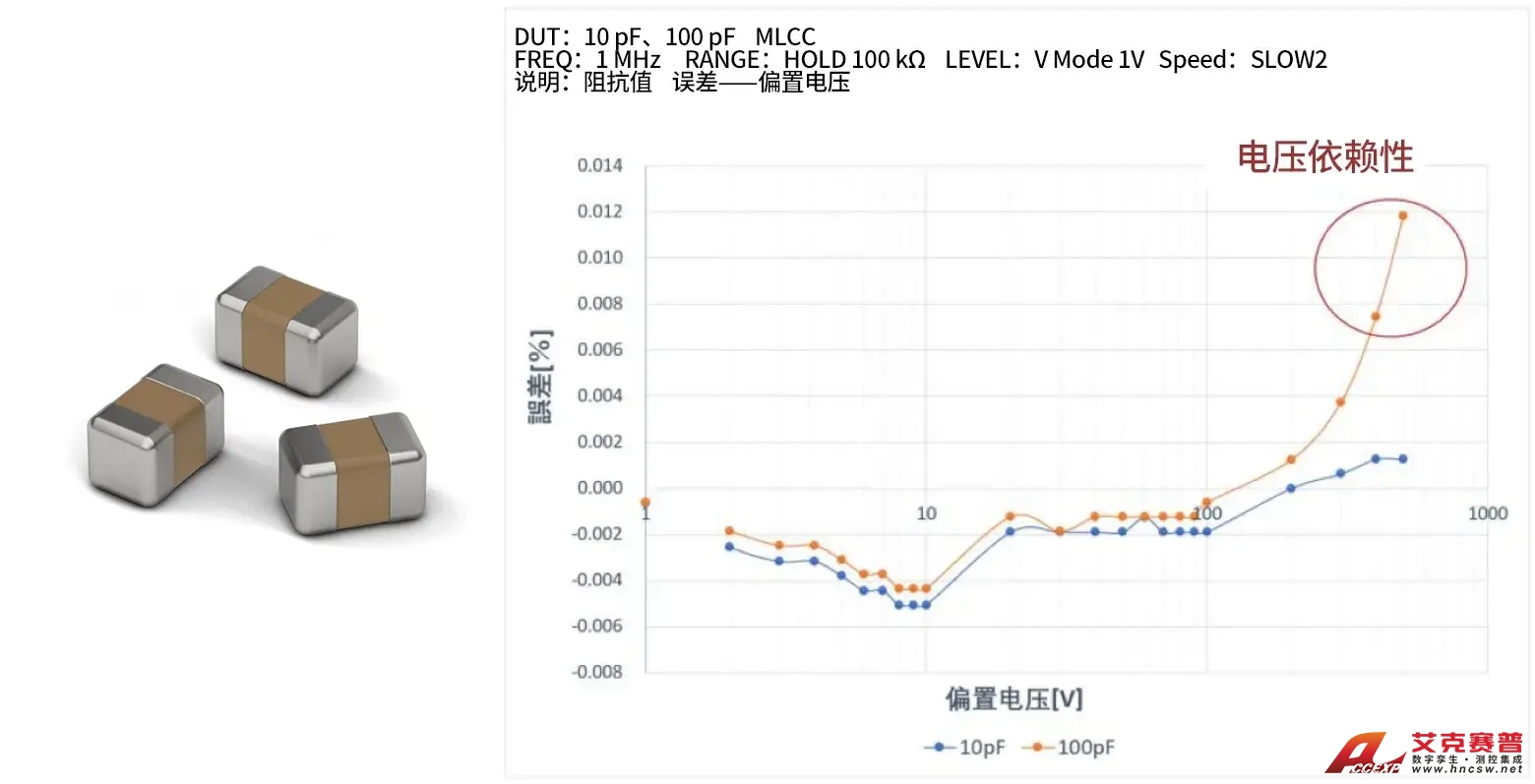
2、二极管结电容
结电容是二极管的寄生参数。由内部载流子的物理特性形成的电容效应可以看作是与二极管并联的等效电容。结电容分为势垒电容和扩散电容。在PN结外施加正偏压时,结电容主要是扩散电容。反向偏置电压作用于PN结时,结电容主要是势垒电容。在高频电路设计中,应根据实际情况考虑结电容的影响。
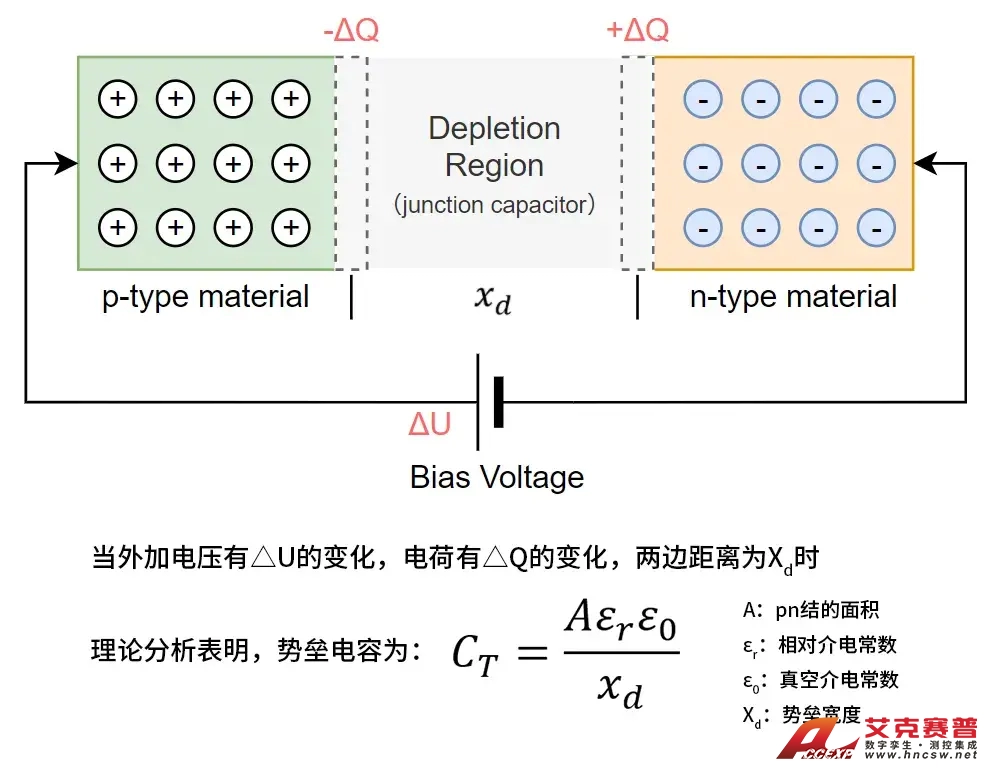
3、MOSFET的寄生电容&米勒效应
一般MOSFET的Datasheet中与寄生电容相关的参数为表中的Ciss、Coss、Crss,这三项是影响开关特性的重要参数,制造商将开关特性分为动态特性(Dynamic Characteristic),应标记相关试验条件,以供工程师参考。上述寄生电容取决于漏源极电压VDS。当VDS增大时,C值趋于减小。HIOKI日置的C-V解决方案可以描绘出各寄生参数关于VDS的特性曲线。
下面简单介绍MOSFET的一般动作过程:可以简单地理解为MOSFET的输入电容(主要是栅源电容CGS)通过驱动源的充放电过程;当CGS达到阈值电压时,MOS管逐渐开启。然后VDS开始下降,Id开始上升,MOS管进入饱和区。然而,由于米勒效应,VGS在一段时间内不会上升。虽然ID已达到峰值,但VDS继续下降,直到米勒电容器完全充电,VGS恢复到驱动电压值。此时,VDS完全归零,开口结束。
上述动态过程影响MOS的许多特性,如动作时间、驱动容量和开关损耗,在驱动电路的设计中经常对这些特性进行评估和考虑。
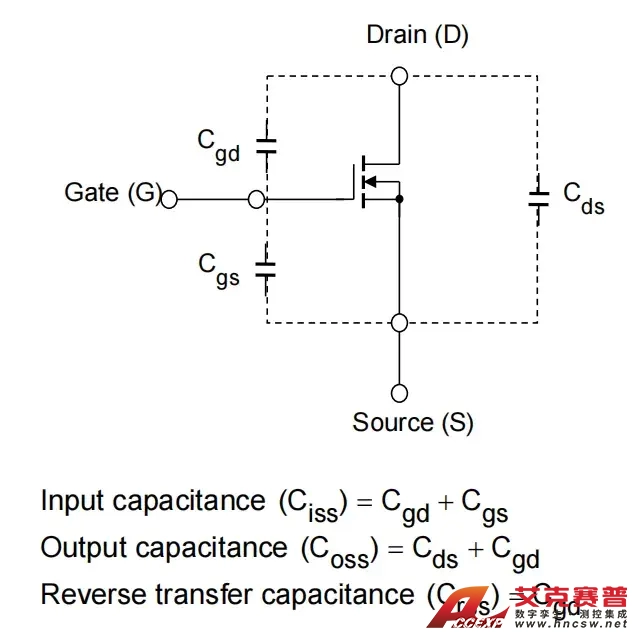
(图1)电容等效电路
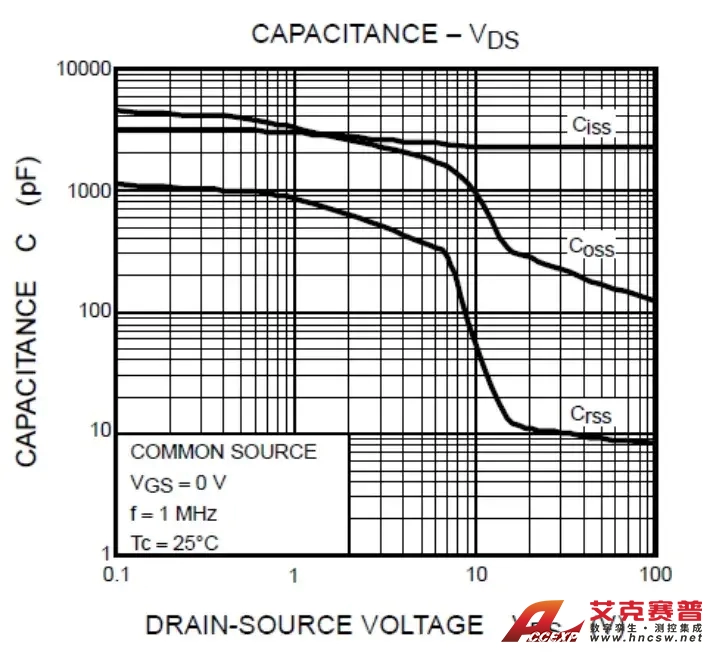
(图2)电容与 VDS
三、系统构成
CN010电压偏置测试系统由HIOKI日置LCR测试仪/阻抗分析仪、电压偏置单元、电源及通讯设备构成。具体可参考下文的参数规格。
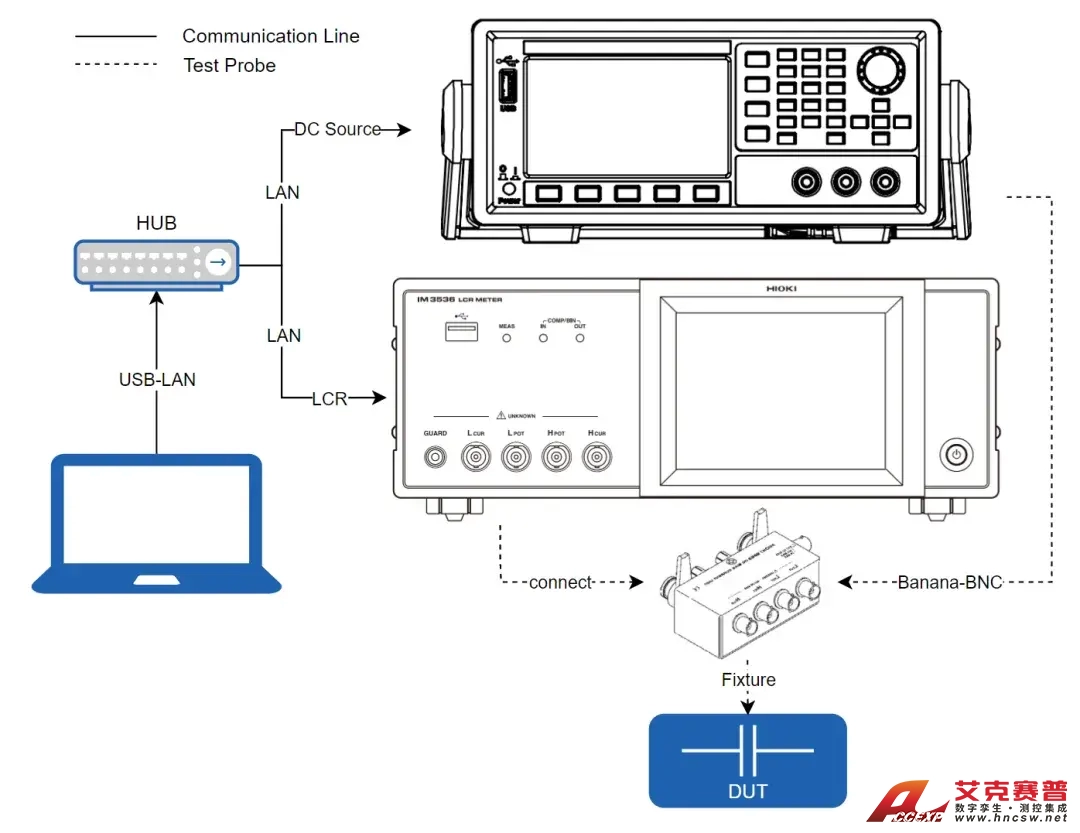
四、参数规格
1、主机规格
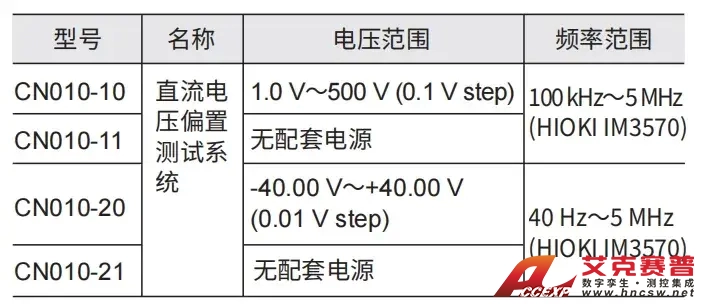
2、产品参数

五、结语
电压偏置测试系统CN010拥有丰富的选件,硬件系统涵盖了广泛的测试需求,通过全面的性能评估和预验证,为客户提供可靠、准确的测试方案。同时,其友好的图标显示界面和实时数据保存可以帮助用户提高开发效率。
艾克赛普公司(Accexp)是日置HIOKI湖南授权代理商,如果您对电压偏置测试系统有需求,欢迎联系我们,将提供免费样机试用和更合适的测试解决方案。
最新资讯











































